日志
[ZZ]功率MOSFET及其发展浅说
热度 1| ||
ElementaryIntroductionofPowerMOSFETandIt'sDevelopment
近年来作了多次关于功率半导体器件发展趋势的报告,许多朋友都希望我讲得更详细些,或更能符合应用工作者的口味,因而撰写一篇现代功率半导体器件浅说的想法由来已久。只是由于设想太大,久久未能动笔。现在从功率MOSFET写起,作为现代功率半导体器件浅说之一,以后再接着写之二、之三,这样就免于搁浅。本文是一种尝试,希望能使读者对现代功率半导体器件的发展有较深入的理解,能更主动地以新一代的器件去改进自己的电路。既是一篇浅说,就需要把基本原理讲得尽可能浅显些。使大家像读故事书那样把技术弄清楚。有的解释或许不够严格。如果我忽略了一些主要的东西,希望读者能协助我予以改正。
由于世界市场的激烈竞争,各功率半导体器件制造商正投入大量资金发展新的设计、改进新的工艺、开发新的产品。好些产品甚至每个季度都有新的发展,品种的更新换代几乎到了使人眼花缭乱的程度。因此详细介绍器件发展的新趋势,就显得更为必要了。
本文从功率MOSFET开始来介绍现代功率半导体器件,这是因为功率MOSFET是新一代功率半导体器件的起点。同时,从器件的结构来说,功率MOSFET也属于最基本的结构之一。
图1所示为IR功率MOSFET的基本结构。图中每一个六角形是一个MOSFET的原胞(cell)。正因为原胞是六角形的(hexangular),因而IR常把它称为HEXFET。功率MOSFET通常由许多个MOSFET原胞组成。已风行了十余年的IR第三代(Gen-3)HEXFET每平方厘米约有18万个原胞,目前世界上密度最高的IR第八代(Gen-8)HEXFET每平方厘米已有1740万个原胞。这就完全可以理解,现代功率半导体器件的精细工艺已和微电子电路相当。新一代功率器件的制造技术已进入亚微米时代。

图1
图1中已标明了漏(Drain)和源(Source)。漏源之间的电流通过一个沟道(Channel)上的栅(Gate)来控制。按MOSFET的原意,MOS代表金属(Metal)-氧化物(Oxide)-半导体(Semiconductor),即以金属层(M)的栅极隔着氧化层(O)利用电场的效应来控制半导体(S)。FET(FieldEffectTransistor场效应晶体管)的名字也由此而来。然而我们从图1中可以看到,HEXFET中的栅极并不是金属做的,而是用多晶硅(Poly)来做栅极,这也就是图中所注明的硅栅极(SiliconGate)。IR在1978年时是用金属做栅极的,1979年的Gen-1HEXFET是世界上第一个采用多晶硅栅极的多原胞型功率MOSFET。
作为功率MOSFET来说,有两项参数是最重要的。一个是Rds(on),即通态时的漏源电阻。另一个是Qg,即栅极电荷,实际即栅极电容。栅极电容细分起来可分成好几个部分,与器件的外特性输入与输出电容也有较复杂的关系。除此之外有些瞬态参数也需要很好考虑,这些我们留到后面再谈。
1通态漏源电阻Rds(on)的降低
为降低Rds(on),先要分析一下Rds(on)是由哪些部分组成。图2列出了芯片中的各部分的电阻。这些电阻主要包括:
RCH:沟道电阻,即栅极下沟道的电阻。
RJ:JFET电阻,即把各原胞的P-基区(P-Base)所夹住的那部分看为JEFT。JEFT是结型场效应晶体管(JunctionFET)的简称。结型场效应管是以PN结上的电场来控制所夹沟道中的电流。虽同称为场效应晶体管,但它和MOSFET是以表面电场来控制沟道中的电流情况不同,所以MOSFET有时也被称为表面场效应管。
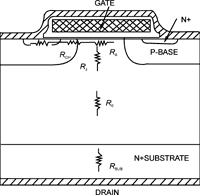
图2
RD:漂移层电阻,主要是外延层中的电阻。一般做功率MOSFET都采用外延片。所谓外延片即在原始的低阻衬底(substrate)硅片上向外延伸一层高阻层。高阻层用来耐受电压,低阻衬底作为支撑又不增加很多电阻。对MOSFET来说,载流子(电子或空穴)在这些区域是在外界电压下作漂移(Drift)运动,故而相关的电阻称为RD。若要求MOSFET的耐压高,就必须提高高阻层(对N沟道MOSFET来说,称N-层)的电阻率,但当外延层的电阻率提高时,RD也随之提高。这也是很少出现一千伏以上的高压MOSFET的原因。
(1)降低沟道电阻
首先我们来看如何降低沟道电阻。前面已经提到,当前功率MOSFET发展的一个重要趋势就是把单个原胞的面积愈做愈小,原胞的密度愈做愈高,其原因就是为了降低沟道电阻。为什么提高原胞的密度可降低沟道电阻呢?从图一可以看出:HEXFET的电流在栅极下横向流过沟道。其电阻的大小和通过沟道时的截面有关。而这个截面随器件内原胞周界的增长而增大。当原胞密度增大时,在一定的面积内,围绕着所有原胞的总周界长度也迅速扩大,从而使沟道电阻得以下降。
IR公司1995年发展的第五代HEXFET,其原胞密度已比第三代大5倍。因此通过同样电流时的硅片面积有希望缩小到原来的2/5。第五代的另一个特点是,其工艺大为简化,即从第三代的6块光刻板减为4块,这样器件的制造成本就可能降低。当今世界上最流行的仍是IR的第三代和第五代,第三代常用于较高电压的器件(如200~600伏),而第五代常用于较低电压的器件(如30~250伏)。高密度结构在较低电压器件中显示更优越作用的原因是因为低压器件的体电阻RD较小,因而降低沟道电阻更易于显出效果。过去有多年工作经验的电力电子工作者,常对当前生产厂热中于发展低压器件不感兴趣或不可理解。这主要是电力电子技术的应用面已大大拓宽,一些低压应用已成为新技术发展中的关键。最典型的是电脑中电源的需求。正在研究的是1伏甚至到0.5伏的电源,同时必须迅速通过50或100安这样大的电流,这种要求对半导体器件是十分苛刻的。就像要求一个非常低压力的水源,瞬间流出大量的水一样。
为进一步增加原胞密度,也可以采用挖槽工艺。通常称为trench(沟槽)MOSFET。图3(a)将沟槽结构作了一个简单图示。沟槽结构的沟道是纵向的,所以其占有面积比横向沟道为小。从而可进一步增加原胞密度。有趣的是,最早做功率稍大的垂直型纵向MOSFET时,就是从挖槽工艺开始的,当初称为VVMOS,但由于工艺不成熟,因而只有当平面型的VDMOS出现后,才有了新一代的功率半导体器件的突破。在半导体器件的发展过程中,因为半导体工艺的迅速发展,或是一种新的应用要求,使一些过去认为不成熟的技术又重新有了发展,这种事例是相当普遍的。当前一统天下的纵向结构功率MOSFET,也有可能吸纳横向结构而为低压器件注入新的发展方向。
(2)降低JFET电阻
为降低JFET电阻,很早就采用了一种工艺,即增加所夹沟道中的掺杂浓度,以求减小JFET的沟道电阻。
沟槽式结构也为降低JFET电阻带来好处。从上

图3
述图3(a)中也可以看出,原结构中的JFET在沟槽型结构中已经消失。这也就使其Rds(on)得以进一步下降。然而沟槽式的缺点是其工艺成本要比原平面型的结构较高。
(3)降低漂移电阻
上面的讨论已涉及到如何降低沟道电阻RCH和JFET电阻RJ。现在剩下的是如何来减小芯片的体电阻RD。上面已经提到,当要求MOSFET工作于较高电压时,必需提高硅片的电阻率。在双极型晶体管中(晶闸管也一样),有少数载流子注入基区来调节体内电阻,所以硅片电阻率的提高对内阻的增加影响较小。但MOSFET则不属于双极型晶体管,它依赖多数载流子导电,所以完全是以外延层的电阻率来决定其Rd。因而使MOSFET的Rds(on)与器件耐压有一个大概2.4到2.6次方的关系。即要求器件的耐压提高时,其Rds(on)必然有一个十分迅速的上升。这也是为什么在600伏以上常采用IGBT的原因。IGBT是绝缘栅双极型晶体管的简称,IGBT虽然结构与MOSFET相似,但却是一种双极型器件。它也是采用少数载流子的注入来降低其体电阻的。
一个十分聪明的构思又为功率MOSFET提供了一条新出路。如果N-沟道MOSFET中的P基区(如图3(b))向体内伸出较长形成一个P柱。则当漏源之间加上电压时,其电场分布就会发生根本的变化。通常PN结加上电压时,电位线基本上是平行于PN结面的。但这种P柱在一定的设计下可使电位线几乎和元件表面平行。就像P柱区和N-区已被中和为一片高阻区一样。于是就可以采用较低的电阻率去取得器件较高的耐压。这样,Rds(on)就因较低的电阻率而大大下降,和耐压的关系也不再遵循前面所提到的2.4到2.6次方的关系了。这样一种思路为MOSFET拓宽了往高压的发展,今后和IGBT在高压领域的竞争就大为有利了。
通过上面的各种努力,IR公司MOSFET的Rds(on)正逐年下降,或者说,正在逐季下降。应用工作者如何抓住机会跟上器件的发展,及时把更好性能的器件用上去,就变得十分重要了。
2栅电荷Qg的降低
MOSFET常常用在频率较高的场合。开关损耗在频率提高时愈来愈占主要位置。降低栅电荷,可有效降低开关损耗。
为了降低栅电荷,从减小电容的角度很容易理解在制造上应采取的措施。从图4可以看到,为减小电容,增加绝缘层厚度(在这儿是增加氧化层厚度)当然是措施之一。减低电容板一侧的所需电荷(现在是降低沟道区的搀杂浓度)也是一个相似的措施。此外,就需要缩小电容板的面积,这也就是要减小栅极面积。缩小原胞面积增加原胞密度从单个原胞来看,似乎可以缩小多晶层的宽度,但从整体来讲,其总的栅极覆盖面积实际上是增加的。从这一点来看,增加原胞密度和减小电容有一定的矛盾。
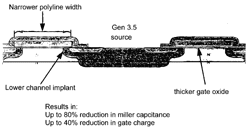
图4
采用了上述措施,IR产生了第3.5代。也称为低栅电荷MOSFET。第3.5代的米勒电容下降80%,栅电荷下降40%。当然第3.5代还有许多其它措施来降低Rds(on)(降低了15%),这样所带来的好处不仅是开通速度快了,温升降低了,也带来了dv/dt能力的提高,栅漏电压的增高,同时也降低了驱动电路的费用。所以对应用工作者来说,将大家最为熟悉的第三代改换用第3.5代的时机已经来到。
为缓解原胞密度增高后栅面积增大引起栅电荷过分增大的问题,一种折衷的结构也随之出现。那就是将漏极的原胞结构改为条状漏极。这时候可以有同样窄的栅极(条密度很高)而不至于增加太多栅极面积,所以栅电荷得以减小。
请原谅我暂时还不能把IR公司的某一代技术和上述的结构联系得过分明确,因为公司也许不容许我这样做。但我相信我已经把联系器件主要参数的基本原理都说清楚了。为了帮助大家记忆,可以粗略地把IR用于高压的器件归纳为第3、6、9代,其中当然包括3.5代。而用于低压的则为5、7、8代。这样如果大家以后在IR的有关报告中听到这些,也就不至于迷惑了。
3动态性能的改进
熟悉电力电子技术的人,早已很了解除了要考虑器件的电压、电流、频率而外,还必须懂得在应用中如何保护器件,不使器件在瞬态变化中受损害。这在当年应用晶闸管时是如此,现在同样也应有相应的考虑。当然晶闸管是两个双极型晶体管的组合,又加上因大面积带来的大电容,所以其dv/dt能力是较为脆弱的。对di/dt来说,它还存在一个导通区的扩展问题,所以也带来相当严格的限制。
功率MOSFET的情况有很大的不同。它的dv/dt及di/dt的能力常以每纳秒(而不是每微秒)的能力来估量。但尽管如此,它也存在动态性能的限制。这些我们可以从功率MOSFET的基本结构来予以理解。
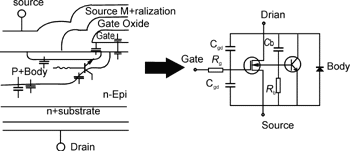
图5MOSFET剖面与等效电路图
图5是功率MOSFET的结构和其相应的等效电路。除了器件的几乎每一部分存在电容以外,还必须考虑MOSFET还并联着一个二极管。同时从某个角度看、它还存在一个寄生晶体管。(就像IGBT也寄生着一个晶闸管一样)。这几个方面,是研究MOSFET动态特性很重要的因素。
首先MOSFET结构中所附带的本征二极管具有一定的雪崩能力。通常用单次雪崩能力和重复雪崩能力来表达。当反向di/dt很大时,二极管会承受一个速度非常快的脉冲尖刺,它有可能进入雪崩区,一旦超越其雪崩能力就有可能将器件打坏。作为任一种PN结二极管来说,仔细研究时其动态特性是相当复杂的。它们和我们一般理解PN结正向时导通反向时阻断的简单概念很不相同。当电流迅速下降时,二极管有一阶段失去反向阻断能力,即所谓反向恢复时间。PN结要求迅速导通时,也会有一段时间并不显示很低的电阻。在功率MOSFET中一旦二极管有正向注入,所注入的少数载流子也会增加作为多子器件的MOSFET的复杂性。
功率MOSFET的设计早已采取措施使其中的寄生晶体管尽量不起作用。在不同代功率MOSFET中其措施各有不同,但总的原则是使漏极下的横向电阻Rb尽量小。因为只有在漏极N区下的横向电阻流过足够电流为这个N区建立正偏的条件时,寄生的双极性晶闸管才开始发难。然而在严峻的动态条件下,因dv/dt通过相应电容引起的横向电流有可能足够大。此时这个寄生的双极性晶体管就会起动,有可能给MOSFET带来灾难。所以考虑瞬态性能时对功率MOSFET器件内部的各个电容(它是dv/dt的通道)都必须予以注意。
瞬态情况是和线路情况密切相关的。这方面对应用有研究的专家会给你最好的指导。如果对器件有了深入理解,将大大有利于理解和分析相应的问题。
值得注意的是,为了追求更低Rds(on)的MOSFET,同时又要求有更快速的性能,一种完全崭新结构的MOSFET还会出现。请容许我今后不断补充和更新这方面的有关知识,我想今后应注明“浅说”是属于哪年的版本,因为新的革新实在是发展得太快了。
REF:https://tech.hqew.com/fangan_544199

 /1
/1 


 eetop公众号
eetop公众号 创芯大讲堂
创芯大讲堂 创芯人才网
创芯人才网