日志
【技术】BGA封装焊盘的走线设计
| |
BGA是一种芯片封装的类型,英文 (Ball Grid Array)的简称,封装引脚为球状栅格阵列在封装底部,引脚都成球状并排列成一个类似于格子的图案,由此命名为BGA。
主板控制芯片诸多采用此类 封装技术 ,采用BGA技术封装的内存,可以使其在体积不变的情况下,容量提高2-3倍,BGA与TSOP相比,体积更小、散热和电性能更好。
BGA封装焊盘走线设计
1
BGA焊盘间走线
设计时,当BGA焊盘 间距小于10mil ,两个BGA焊盘中间 不可走线 ,因为走线的线宽间距都超出生产的工艺能力,除非减小BGA焊盘,在制作生产稿时保证其间距足够,但当焊盘被削成异形后,可能导致焊接位置不准确。

2
盘中孔树脂塞孔电镀填平
当BGA封装的焊盘间距小而无法出线时,需设计盘中孔,将孔打在焊盘上面,从内层走线或底层走线,这时的盘中孔需要 树脂塞孔电镀填平 ,如果盘中孔不采取树脂塞孔工艺,焊接时会导致焊接不良,因为焊盘中间有孔焊接面积少,并且孔内还会漏锡。
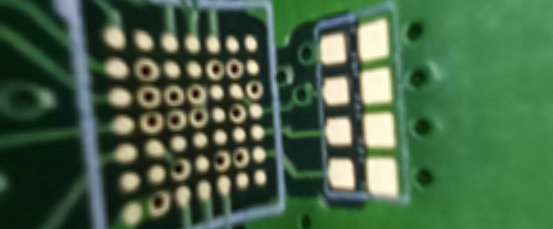
3
BGA区域过孔塞孔
BGA焊盘区域的过孔一般都需要 塞孔 ,而样板考虑到成本以及生产难易度,基本过孔都是 盖油 ,塞孔方式选择的是油墨塞孔,塞孔的好处是防止孔内有异物或保护过孔的使用寿命,再者是在SMT贴片过回流焊时,过孔冒锡会造成另一面开短路。

4
盘中孔、HDI设计
引脚间距较小的BGA芯片,当超出工艺制成引脚焊盘无法出线时,建议直接设计 盘中孔 ,例如手机板的BGA芯片比较小,且引脚多,引脚的间距小到无法从引脚中间走线,就只能采取HDI盲埋孔布线方式设计PCB,在BGA焊盘上面打盘中孔,内层打埋孔,在内层布线导通。
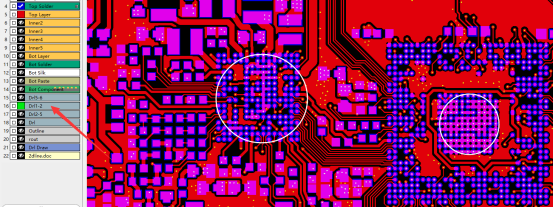
BGA焊接工艺
1
印刷锡高
焊膏印刷的目的,是将适量的锡膏均匀施加在PCB焊盘上,以保证贴片元器件与PCB相对应的焊盘再回流焊接时,达到良好的 电气连接 ,并具有足够的机械强度,印刷锡膏需要制作钢网,锡膏通过各焊盘在钢网上对应的开孔,在刮刀的作用下,将锡均匀的涂覆在各焊盘上,以达到良好焊接的目前。
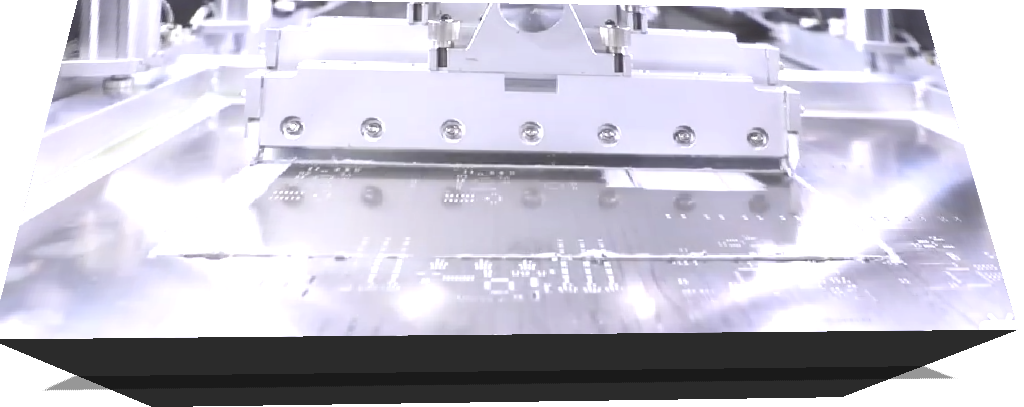
2
器件放置
器件放置就是 贴片 ,用贴装机将片式元器件,准确的贴装到印好锡膏或贴片胶的PCB表面相应的位置,高速贴片机,适用于贴装小型大量的组件,如电容,电阻等,也可贴装一些IC组件;泛用贴片机,适用于贴装异性或精密度高的组件,如QFP,BGA,SOT,SOP,PLCC等。

3
回流焊接
回流焊是通过熔化电路板焊盘上的锡膏,实现表面组装元器件焊端与PCB焊盘之间的机械与电气连接,形成 电气回路 ,回流焊作为SMT生产中的关键工序,合理的温度曲线设置是保证回流焊质量的关键,不恰当的温度曲线会使PCB板出现焊接不全、虚焊、元件翘立、焊锡球过多等焊接缺陷,影响产品质量。
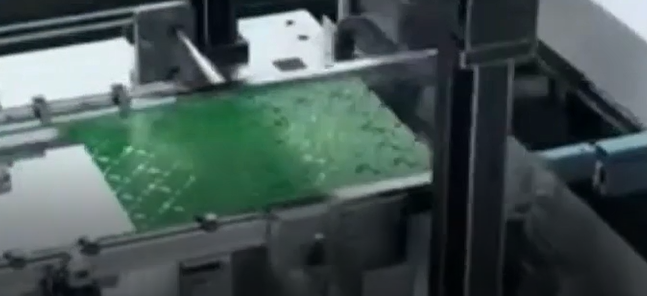
4
X-Ray检查
X-Ray几乎可以检查全部的工艺缺陷,通过其透视特点,检查焊点的形状,和电脑库里标准的形状比较,来判断 焊点的质量 ,尤其对BGA、DCA元件的焊点检查,作用不可替代,无须测试模具,缺点是价格目前相当昂贵。

BGA焊接不良原因
1
BGA焊盘孔未处理
BGA焊接的焊盘上有孔,在焊接过程中 焊球会与焊料一起丢失 ,由于PCB生产中缺乏电阻焊接工艺,焊锡和焊球会通过靠近焊板的孔而流失,从而导致焊球流失。

2
焊盘大小不一
BGA焊接的焊盘大小不一,会影响焊接的品质良率,BGA焊盘的出线,应 不超过焊盘直径的50% ,动力焊盘的出线,应 不小于0.1mm ,且可以加粗,为防止焊接盘变形,焊接阻挡窗不得大于0.05mm,铜面上的开窗,应与线路PAD一样大,否则BGA焊盘做出来大小不一。
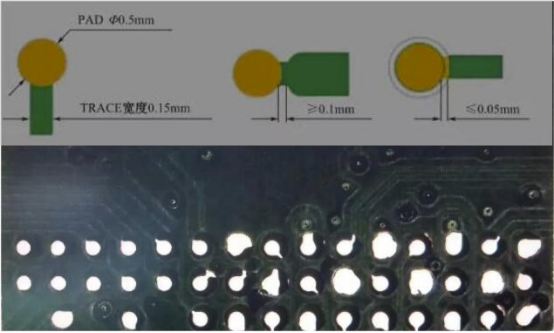
快速解决BGA焊接问题
因前期设计不当,而在生产中引发相关问题的情况屡见不鲜,那有什么办法可以一劳永逸,提前解决生产困扰呢?这里不得不提到一款可以完美避开生产风险的软件: 华秋DFM 。
1
封装的盘中孔
使用华秋DFM一键分析功能,检测设计文件是否存在盘中孔,提示设计工程师存在盘中孔是否需要修改文件不做盘中孔设计,因为盘中孔制造成本非常高,如能把盘中孔改为普通孔,可减少产品的成本,同时也提醒制造板厂有设计盘中孔,需做树脂塞孔走盘中孔生产工艺。
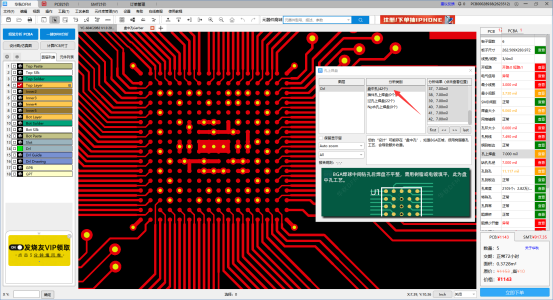
2
焊盘与引脚比
使用华秋DFM组装分析功能,检测设计文件的BGA焊盘与实际器件引脚的大小比例,焊盘直径比BGA引脚小于20%,可能存在焊接不良问题,大于25%则使布线空间变小,此时需设计工程师调整焊盘与BGA引脚直径的比例。
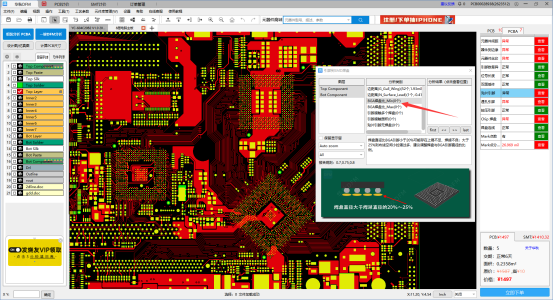
华秋DFM软件针对BGA焊盘等问题,具有详尽的 可焊性解决方案 ,生产前帮助用户评审BGA设计文件的可焊性,避免在组装过程中出现BGA芯片的可焊性问题,并提示BGA芯片存在可焊性品质良率等。

目前华秋DFM软件推出了新版本,可实现制造与设计过程同步,模拟选定的PCB产品从设计、制造到组装的整个生产流程。
华秋DFM使BOM表整理、元器件匹配、裸板分析及组装分析四个模块相互联系,共同协作来完成一个完整的DFM分析

 /1
/1 

 eetop公众号
eetop公众号 创芯大讲堂
创芯大讲堂 创芯人才网
创芯人才网